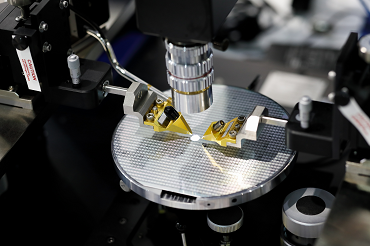
♦ 露光技術50年の変遷たどる
1.半導体露光装置:フォトリソグラフィ工程の要
CPUやメモリなどの半導体はフォトリソグラフィ工程を用いて製造されています(図1)。この工程で要となるのが半導体露光装置です。この50年でCPU内トランジスタ数は100万倍程度に増加しましたが (図2)、これは露光装置の解像力の進化なくしては成しえませんでした。ここでその進化を支えた光学技術について述べてみたいと思います。
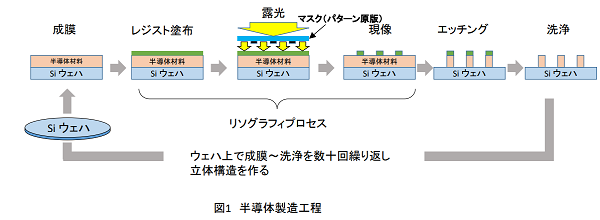

2.解像力の定義
解像力はレーリーの式で定義されます。
- 解像力 =k1 × λ/NA … (1)
- 焦点深度=k2 × λ/NA² … (2)
λ:露光波長 NA:レンズの開口数(図3)
k1、k2:レジスト条件等で変わる係数
1970年代、限界解像力はg線(λ=436nm)を用いて2µm程度といわれていました。しかしその後の光学技術の進化で、解像力は大幅に向上していきました。
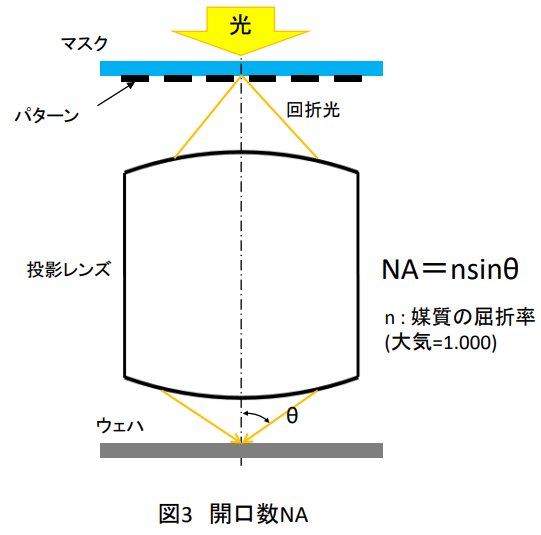
3.高解像力に向けた技術革新
3.1 露光方式の変遷
露光方式の変遷を図4に示します。高解力化の求めに応え1970年代後半に登場したのが結像光学系を組込んだ2種類の露光装置、Mirror ProjectionとStepper(図5)です。これらの違いは、前者はミラーによる等倍光学系、後者はレンズによる1/5倍縮小光学系という点です。...